如今器件小型化、高性能以及降低成本发展趋势对于产品封装提出了更为严格的市场需求,随着技术进步,业内提出了晶圆级封装(包括 fan-out wlp、fan-in wlp)、flipchip和2.5d/3d 等先进封装金沙下载送彩金的解决方案。
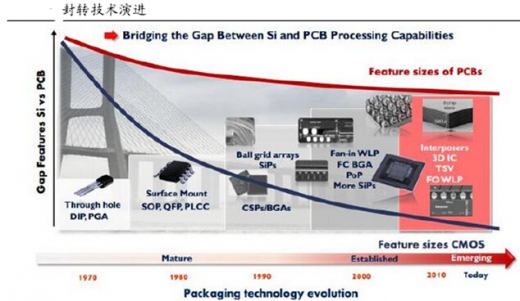
晶圆级封装(wlp):是整片晶圆生产完成后,直接在晶圆上进行封装测试,完成之后才切割制成单颗 ic,封装后的尺寸等同晶粒原来大小。传统的 wlp多采用扩散型晶圆级封装(fan-in wlp),但是伴随 ic 信号输出的接脚数目增加,衍生出扩散型晶圆级封装(fan-out wlp)。
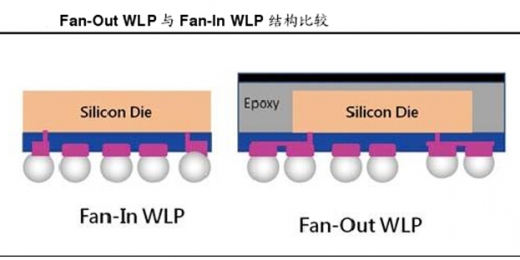
倒装芯片 flip chip:传统封装采用将芯片的有源区面朝上,背对基板键合,而倒装芯片将有源面朝下,与基板布线层直接键合。
2.5d/3d:是把不同功能的芯片或结构,通过堆叠技术,使其在垂直方向上形成立体集成和信号连通。
受益于 fan-out wlp 和 2.5d/3d 的大量应用,以及 fan-in wlp 和 flip-chip的稳步增长,yole 预测,先进封装市场营收将从 2014 年 192 亿美元增长到 2020年的 317 亿美元,复合年增率为 8%。先进封装目前占据整个封装市场的 38%市场份额,预计 2020 年将增长至 46%。

据不完全统计,在国内布局的封测企业中,17 家涉及先进封装领域,半数是中国企业。中国主要的封测厂商包括长电科技、华天科技、通富微电和晶方半导体都具有先进封装能力。

【金沙下载送彩金的版权提示】观研报告网倡导尊重与保护知识产权。未经许可,任何人不得复制、转载、或以其他方式使用本网站的内容。如发现本站文章存在金沙下载送彩金的版权问题,烦请提供金沙下载送彩金的版权疑问、身份证明、金沙下载送彩金的版权证明、金沙下载送彩金的联系方式等发邮件至kf@chinabaogao.com,我们将及时沟通与处理。
